Waarom en hoe GaN-veldeffecttransistors toe te passen voor efficiënte, hogere spanning, schakelende vermogenstoepassingen
Bijgedragen door De Noord-Amerikaanse redacteurs van DigiKey
2023-01-26
Energie-efficiëntie is een prioriteit voor elektronische systemen in het licht van zowel maatschappelijke als wettelijke eisen. Met name voor toepassingen variërend van elektrische voertuigen (EV's) tot hoogspanningscommunicatie en industriële infrastructuur zijn vermogensomzettingsefficiëntie en vermogensdichtheid van cruciaal belang voor het succes van het ontwerp.
Om aan deze eisen te voldoen, moeten ontwerpers van schakelende energiesystemen afstappen van het gebruik van klassieke, op silicium (Si) gebaseerde metaaloxide-veldeffecttransistors (MOSFET's) en bipolaire transistors met geïsoleerde gate (IGBT's), aangezien deze snel hun theoretische grenzen naderen.
In plaats daarvan moeten ontwerpers apparaten overwegen die gebaseerd zijn op materialen met een grote bandbreedte (WBG), zoals galliumnitride (GaN). GaN-apparaten schakelen sneller dan Si-apparaten, kunnen hogere spannings- en vermogensniveaus aan, zijn veel kleiner voor een bepaald vermogensniveau en werken met een veel hogere efficiëntie.
In dit artikel worden de grondbeginselen van GaN FET's besproken, de voordelen ervan ten opzichte van traditionele Si-apparaten in schakelkringen, praktijkvoorbeelden van Nexperia en de toepassing ervan.
De grondbeginselen van GaN FET's
De fundamentele elementen in stroomconversieschakelingen zijn hoogspanningshalfgeleiderschakelaars. Ontwerpers hebben zich gericht op verbetering van de prestaties van deze apparaten door: verlaging van de geleidingsverliezen door vermindering van de serieweerstand in de staat, verlaging van de schakelverliezen door verhoging van de overgangssnelheden en vermindering van parasitaire effecten. Deze ontwerpinspanningen zijn in het algemeen succesvol geweest voor silicium MOSFET's en IGBT's, maar het tempo van de verbeteringen neemt af naarmate de werking van deze apparaten hun theoretische grenzen bereikt.
Als gevolg daarvan zijn de afgelopen jaren WBG-apparaten geïntroduceerd die gebruik maken van siliciumcarbide (SiC) en GaN, en wel in die mate dat zij nu in grote hoeveelheden worden geproduceerd. Deze apparaten bieden hogere werkspanningsbereiken, snellere schakeltijden en een hoger rendement.
De bandkloof van een halfgeleider is de minimale energie die nodig is om elektronen uit hun gebonden toestand te laten overgaan in een vrije toestand om elektriciteit te geleiden (Tabel 1).
|
Tabel 1: Een overzicht van de belangrijkste eigenschappen die halfgeleiders met groot bereik, zoals GaN en SiC, onderscheiden van Si. (Bron tabel: Art Pini)
Apparaten gemaakt met halfgeleiders met grote bandbreedte kunnen werken bij veel hogere spanningen, frequenties en temperaturen dan conventionele halfgeleidermaterialen zoals Si. De grotere bandkloof is bijzonder belangrijk om apparaten bij veel hogere temperaturen te laten werken. De hoge temperatuurtolerantie betekent dat deze apparaten onder normale omstandigheden op veel hogere vermogens kunnen werken. WBG-halfgeleiders met een hoger kritisch elektrisch veld en een hogere mobiliteit hebben de laagste drain-bron on-state weerstand (RDS(ON)), waardoor de geleidingsverliezen afnemen.
De meeste brede bandkloof materialen hebben ook hoge vrije-elektronensnelheden, waardoor ze met hogere schakelsnelheden kunnen werken.
Vergeleken met Si, dat een bandkloof heeft van 1,12 elektronvolt (eV), zijn GaN en SiC samengestelde halfgeleiders met een bandkloof die ongeveer drie keer zo groot is, respectievelijk 3,4 eV en 3,3 eV. Dit betekent dat beide hogere spanningen en hogere frequenties kunnen ondersteunen.
De hogere elektronenmobiliteit van GaN maakt het veel geschikter voor krachtige, hoogfrequente toepassingen. De hogere schakelsnelheden en hogere werkingsfrequenties van GaN power FET's leiden tot een betere signaalcontrole, passieve filterontwerpen met hogere afsnijfrequenties en lagere rimpelstromen. Dit maakt het gebruik van kleinere spoelen, condensatoren en transformatoren mogelijk, waardoor de totale omvang en het gewicht afnemen.
GaN FET's worden high electron mobility transistors (HEMT) genoemd. De hoge elektronenmobiliteit is een functie van de FET-structuur (Afbeelding 1).
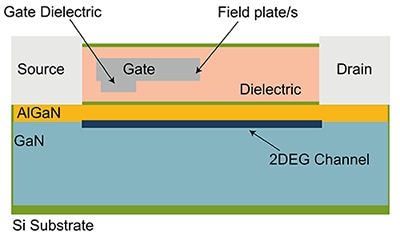 Afbeelding 1: Een dwarsdoorsnede van een GaN FET op basis van een Si-substraat. (Bron afbeelding: Nexperia)
Afbeelding 1: Een dwarsdoorsnede van een GaN FET op basis van een Si-substraat. (Bron afbeelding: Nexperia)
GaN FET's maken gebruik van bestaande silicium CMOS-productiefaciliteiten, waardoor ze kosteneffectief zijn. Een GaN-laag wordt gevormd op het Si substraat door afzetting van een zaadlaag en een getrapte laag van GaN en aluminium galliumnitride (AlGaN) als isolatielaag (niet weergegeven in het diagram) voordat de zuivere GaN-laag groeit. Een tweede AlGaN-laag wordt bovenop de GaN-laag aangebracht. Hierdoor ontstaat een piëzo-elektrische polarisatie, waarbij een overmaat aan elektronen wordt gegenereerd direct onder het AlGaN, dat een zeer geleidend kanaal is. Deze overmaat aan elektronen staat bekend als een tweedimensionaal elektronengas (2DEG). De naam geeft de zeer hoge elektronenmobiliteit in deze laag weer.
Onder de poort wordt een verarmingsgebied gevormd. De werking van de gate is vergelijkbaar met een N-kanaals, versterkingsmodus vermogen silicium MOSFET. Een positieve spanning op de gate van dit apparaat zet het aan.
Deze structuur wordt meerdere malen herhaald om een energieapparaat te vormen. Het eindresultaat is een fundamenteel eenvoudige, elegante, kosteneffectieve oplossing voor stroomschakeling.
Om een apparaat met een hogere spanning te verkrijgen, wordt de afstand tussen de Drain en de Gate vergroot. Aangezien de weerstand van GaN 2DEG zeer laag is, is het effect op de weerstand door verhoging van het vermogen tot blokkeerspanning veel geringer in vergelijking met siliciumapparaten.
GaN FET's kunnen in twee configuraties werken: de versterkingsmodus of de verarmingsmodus. Enhancement mode FET's zijn normaal uitgeschakeld, zodat een positieve spanning ten opzichte van de drain/bron op de gate moet worden gezet om de FET in te schakelen. Depletion mode FET's zijn normaal ingeschakeld, dus moet een negatieve gatespanning ten opzichte van de drain/bron worden aangelegd om de FET uit te schakelen. Depletion mode FET's zijn problematisch in een energiesysteem omdat een negatieve bias moet worden aangelegd op de GaN depletion mode FET voordat het systeem wordt ingeschakeld.
Een manier om dit probleem te omzeilen is het combineren van een laagspannings-Silicium FET met een GaN FET met depletiemodus in een cascode-schakeling (Afbeelding 2).
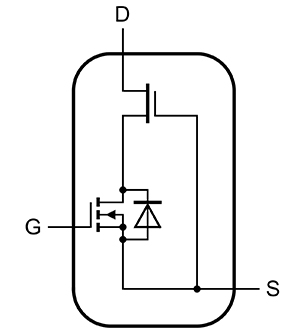 Afbeelding 2: Een laagspannings-Silicium MOSFET in een cascode-configuratie met een GaN FET met depletiemodus resulteert in de robuustheid van de Si gate-structuur met de verbeterde hoogspanningsklokkenmerken van het GaN-apparaat, alsmede het hebben - in het geval van een GaN FET met depletiemodus - van het samengestelde apparaat bij het inschakelen. (Bron afbeelding Nexperia)
Afbeelding 2: Een laagspannings-Silicium MOSFET in een cascode-configuratie met een GaN FET met depletiemodus resulteert in de robuustheid van de Si gate-structuur met de verbeterde hoogspanningsklokkenmerken van het GaN-apparaat, alsmede het hebben - in het geval van een GaN FET met depletiemodus - van het samengestelde apparaat bij het inschakelen. (Bron afbeelding Nexperia)
De cascodekring gebruikt de Si MOSFET-poortstructuur, die de voordelen heeft van hogere gatedrive-limieten in vergelijking met bestaande MOSFET-gate driver IC's, en de GaN FET met verarmingsmodus die bij het inschakelen uitgeschakeld is.
Een van de belangrijkste kenmerken van GaN FET's is hun hoge efficiëntie. Dit is het gevolg van: lage serieweerstand, waardoor de geleidingsverliezen lager zijn; hun snellere schakeltijden, waardoor de schakelverliezen lager zijn; en hun lagere omgekeerde terugwinningslading, die verantwoordelijk is voor hun lage omgekeerde terugwinningsverliezen.
Met behulp van een gemeenschappelijke topologie voor een half-brug boostconvertor is het mogelijk de efficiëntie van GaN FET's en Si MOSFET's te vergelijken (Afbeelding 3).
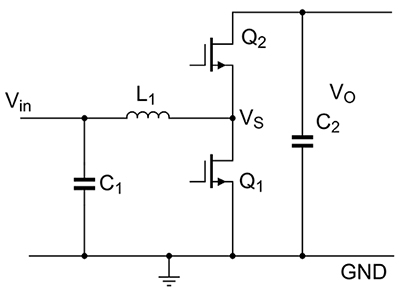 Afbeelding 3: Weergegeven is het schema van een half-brug boostconvertor die wordt gebruikt voor het vergelijken van de efficiëntie van MOSFET's en GaN FET's door transistors Q1 en Q2 te verwisselen met elk type. (Bron afbeelding: Nexperia)
Afbeelding 3: Weergegeven is het schema van een half-brug boostconvertor die wordt gebruikt voor het vergelijken van de efficiëntie van MOSFET's en GaN FET's door transistors Q1 en Q2 te verwisselen met elk type. (Bron afbeelding: Nexperia)
De boostconvertor heeft een ingangsspanning van 240 volt, de uitgang is 400 volt en de schakelfrequentie is 100 kilohertz (kHz). De rendementen en verliezen worden vergeleken over een vermogensbereik tot 3500 watt (Afbeelding 4).
 Afbeelding 4: Een vergelijking van de efficiëntie en het vermogensverlies tussen GaN FET's en MOSFET's in een identieke schakeling, waaruit de voordelen van de GaN FET's blijken. (Bron afbeelding: Nexperia)
Afbeelding 4: Een vergelijking van de efficiëntie en het vermogensverlies tussen GaN FET's en MOSFET's in een identieke schakeling, waaruit de voordelen van de GaN FET's blijken. (Bron afbeelding: Nexperia)
De GaN FET's zijn ongeveer 20% efficiënter dan de MOSFET's, en het vermogensverlies is ongeveer een factor drie lager. Bij 2000 watt bedraagt het verlies in de MOSFET's ongeveer 62 watt; in de GaN FET's is dat slechts 19 watt. Dit betekent dat het koelsysteem kleiner kan zijn, waardoor het volumetrisch rendement van de boostconvertor verbetert.
Minder duidelijk is dat de meting is uitgevoerd tot bijna 3500 watt voor de GaN FET vanwege de hogere maximumspanning. Als zodanig heeft de GaN FET een duidelijk voordeel.
Aan de slag met GaN voor hogere spanningen
Voor toepassingen met een hogere spanning biedt Nexperia twee 650 volt GaN FET's, de GAN063-650WSAQ en de GAN041-650WSBQ. Beide zijn N-kanaals FET's die normaal uit staan. De GAN063-650WSAQ is berekend op een maximale drain-to-source spanning van 650 volt en kan een transiënt (met een pulsbreedte van minder dan een microseconde) van 800 volt aan. Hij is berekend op een afvoerstroom van 34,5 ampère (A) en een vermogensdissipatie van 143 watt bij 25 °C. De drain-to-source on-state weerstand is typisch 50 milliohms (mΩ), met een maximum van 60 mΩ.
De GAN041-650WSBQ heeft dezelfde maximale afvoer-bronspanning van 650 volt en dezelfde transiënte limiet van 800 volt. Het verschil is dat hij een maximale afvoerstroom van 47,2 A en een maximale vermogensdissipatie van 187 watt bij kamertemperatuur aankan. De typische kanaalweerstand is 35 mΩ, met een maximum van 41 mΩ.
Een Nexperia-referentieontwerp met de GAN063-650WSAQ in een half-brugconfiguratie is weergegeven in Afbeelding 5.
 Afbeelding 5: Een aanbevolen ontwerp voor een half-brug vermogenstrap met GAN063-650WSA GaN FET's. Het schema toont alleen de FET-driver en de half-brug eindtrap, en de bijbehorende componenten. (Bron afbeelding: Nexperia)
Afbeelding 5: Een aanbevolen ontwerp voor een half-brug vermogenstrap met GAN063-650WSA GaN FET's. Het schema toont alleen de FET-driver en de half-brug eindtrap, en de bijbehorende componenten. (Bron afbeelding: Nexperia)
Het schema toont de Si8230 hoog/laag dual geïsoleerde gatedriver, die wordt gebruikt om de poorten van de GaN FET's aan te drijven. De uitgang van de gatedriver is verbonden met de gate via een 30 Ω gate weerstand, die vereist is voor alle GaN-apparaten. De gateweerstand regelt de oplaadtijd van de poortcapaciteit en beïnvloedt zo de dynamische schakelprestaties. De R-C netwerken tussen de drain en de source van de FET's helpen ook bij het regelen van de schakelprestaties. De gatedrive-niveaus voor de GaN FET liggen tussen 0 en 10 tot 12 volt.
De hoge schakelsnelheid van de GaN FET's (doorgaans in het bereik van 10 tot 11 nanoseconden (ns)) vereist een zorgvuldige lay-out om de parasitaire inductie te minimaliseren, en het gebruik van RC-snubbers om ringing als gevolg van spannings- en stroomtransiënten te dempen. Er zijn meerdere RC-snubbers (R17 t/m 19 en C33 t/m 35) in het ontwerp tussen de hoogspanningsvoeding en massa. De snubbers verminderen ringvorming door de interactie tussen de GaN FET en het bypass-netwerk. Snubbers moeten zo dicht mogelijk bij de drain van de high-side FET worden aangesloten. Ze zijn uitgevoerd met opbouwweerstanden en keramische condensators met lage effectieve serieweerstand (ESR) om de inductie te minimaliseren.
Het componentennetwerk gevormd door R4,D1, C12 en C13 is een opstartvoeding voor de high-side gatedriver. D1 moet een snelle diode met lage capaciteit zijn, omdat zijn junctiecapaciteit bijdraagt tot het schakelverlies. R4 beperkt de inschakelbare laadstroom; een waarde tussen 10 en 15 Ω werkt goed.
Conclusie
Van EV's tot communicatie en industriële infrastructuur, de behoefte aan een grotere energieomzettingsefficiëntie en vermogensdichtheid vereist een verschuiving van de klassieke Si-structuren. Zoals aangetoond, bieden GaN FET's een oplossing voor ontwerpen van de volgende generatie door hogere bedrijfsspanningen, snellere schakeltijden en een hoger rendement. Kant-en-klare componenten, in sommige gevallen ondersteund door referentieontwerpen, helpen ontwerpers om projecten snel op te starten.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.